Samsung внедрит Hybrid Bonding в HBM4 — вдвое больше I/O и меньше тепла
Компания Samsung официально подтвердила переход на технологию Hybrid Bonding в составе будущей памяти HBM4. Это позволит отказаться от использования микробамперов между слоями чипов и обеспечить вдвое больше линий ввода-вывода (I/O). Если в HBM3E их число ограничено 1024, то в HBM4 ожидается удвоение благодаря плотной укладке без bump-контактов.
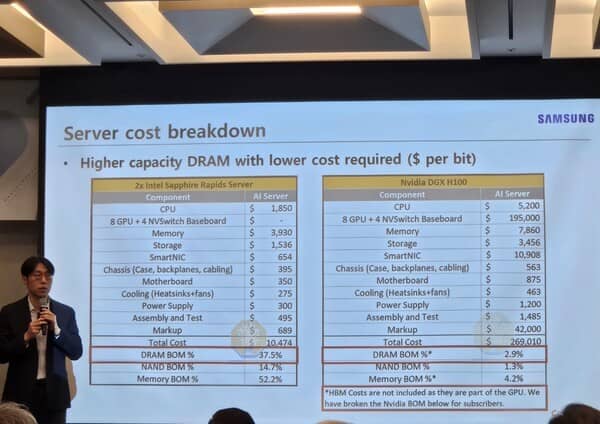
Hybrid Bonding позволит снизить тепловыделение и повысить энергоэффективность. Samsung отмечает, что уже сегодня до 14% всей энергии в дата-центрах уходит на обслуживание памяти, и устранение узких мест в архитектуре DRAM становится приоритетной задачей. Применение прямого соединения кристаллов позволит укладывать больше слоёв памяти в тот же объём, избегая перегрева.
Однако основное препятствие — высокая стоимость оборудования для гибридной сборки. Устройства Hybrid Bonder стоят в несколько раз дороже обычных упаковочных машин и требуют больше площади на производстве, снижая рентабельность. Это стало причиной, по которой SK Hynix, несмотря на готовность технологии, пока не внедряет Hybrid Bonding в серийное производство.
В свою очередь, Samsung надеется компенсировать затраты за счёт внутреннего ресурса. Дочерняя компания Semes готова поставлять собственные упаковочные установки нового поколения, что потенциально позволит снизить цену входа в массовое производство HBM4 с новой архитектурой соединений.
Если тесты пройдут успешно, Samsung получит технологическое преимущество на рынке HBM. Увеличение пропускной способности, улучшенная теплоотдача и энергоэффективность делают гибридную сборку ключевым элементом для продвижения HBM4 в сфере ИИ и дата-центров.




