Intel представляет EMIB-T и новые технологии упаковки чипов: шаг к 1000 Вт, HBM4 и микроканальному охлаждению
На конференции Electronic Components Technology Conference (ECTC) компания Intel представила сразу несколько прорывных технологий упаковки микросхем, которые лягут в основу будущих решений Intel Foundry. В фокусе — три ключевые новинки: технология EMIB-T, раздельный теплораспределитель нового поколения и усовершенствованная термокомпрессионная сборка для крупных чипов.
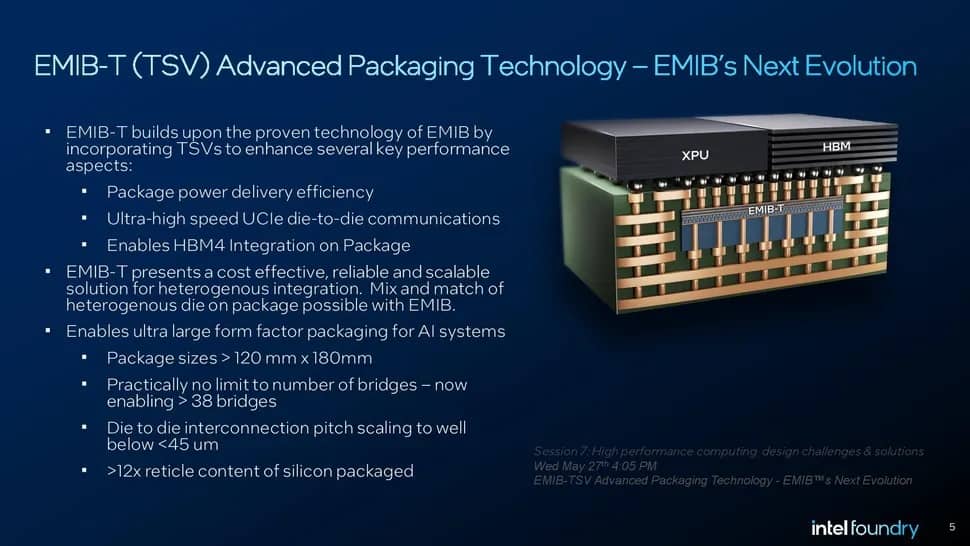
EMIB-T представляет собой развитие существующей технологии EMIB (Embedded Multi-die Interconnect Bridge), в которую добавлены сквозные кремниевые переходы (TSV). Это позволило значительно улучшить питание чиплетов и память HBM4/4e, устранив просадки напряжения, характерные для предыдущих поколений. Кроме того, EMIB-T обеспечивает пропускную способность до 32 Гбит/с и поддержку UCIe-A, а также масштабируемость до более 38 мостов и 12 чиплетов в одном корпусе размером до 120×180 мм. Intel также подтвердила, что новый стандарт будет поддерживать шаг соединений до 25 микрон, что является серьёзным прорывом.
Второй ключевой анонс — новая конструкция теплораспределителя, в которой он разделяется на плоскую пластину и жёсткую рамку. Это обеспечивает лучший контакт с термоинтерфейсом (TIM) и снижает вероятность образования пустот на 25%. Прототипы с микроканальным охлаждением внутри теплораспределителя уже показали эффективность при TDP до 1000 Вт, что крайне важно для будущих AI-ускорителей и серверных решений.
Наконец, Intel представила обновлённый процесс термокомпрессионной сборки, который сводит к минимуму температурный перекос между подложкой и кристаллом при соединении. Это повышает надёжность и выход годной продукции, а также открывает путь к использованию крупных подложек и более плотным шагам соединений.
Все эти технологии призваны укрепить позиции Intel на рынке упаковки чипов, особенно в сфере гетерогенных архитектур, где компоненты CPU, GPU и памяти могут быть объединены в одном корпусе, даже если не все они произведены на фабриках Intel. Услуги упаковки становятся важнейшим направлением Intel Foundry, особенно с учётом контрактов с AWS, Cisco и правительственными проектами SHIP и RAMP-C.




